技術紹介
CFD-ACE+ を用いた SiC CVD シミュレーション( CFD-ACE+ CVD Simulation : chemical vapor deposited silicon carbide )
- Dec 12, 2009 11:20:00 AM
- 株式会社アテナシス 池田 圭
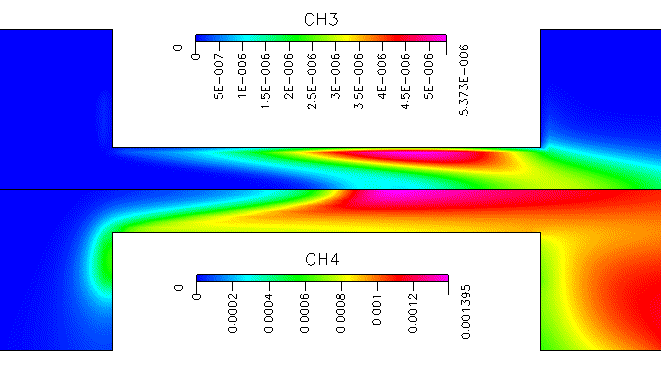
シリコン・カーバイド( Silicon Carbide:SiC )はシリコン( Si )よりも材料の物理特性に優れており,パワーデバイス向けの半導体材料として期待されています( SiC半導体:外部サイト,等).
実験・シミュレーションの両方から検討が以前より進められていますが,以下では,SiC CVD 装置の熱解析モデルを元に,気相・表面の反応を考慮した CVD シミュレーションの例をご紹介します.
参考論文:
Growth rate predictions of chemical vapor deposited silicon carbide epitaxial layers
O. Danielsson, A. Henry, E. Janzen
Journal of Crystal Growth 243 (2002) 170-184
■ 計算モデル
装置の形状・計算モデルは,先の解析例をベースにしていますが,ガス流量等が異なるため,境界条件や電流値等について若干の見直しを行いました.その上で,サセプター(graphite)中央において,論文で述べられている基本条件とされた温度(1600℃)に近い条件を求めました.
考慮した気相反応の数は論文と同じですが,逆反応のレート算出には全て平衡モデルを利用しています(論文では,アレニウス型の速度定数を用いているものと平衡モデルを利用したものが混在しています).考慮した反応ステップの一覧を,以下の表1に示します(反応レートの詳細は論文に記載されており,以下では割愛致します).
表1 シミュレーションで考慮した気相反応( 110 steps )
|
CH4 <-> CH3 + H
|
||||||||||||||||||||||||||||||||||||
|
C2H2 <-> H + C2H
|
||||||||||||||||||||||||||||||||||||
|
C2H4 <-> C2H2 + H2
|
||||||||||||||||||||||||||||||||||||
|
C2H5 <-> H + C2H4
|
||||||||||||||||||||||||||||||||||||
|
C2H6 <-> 2.0 CH3
|
||||||||||||||||||||||||||||||||||||
|
C3H8 <-> CH3 + C2H5
|
||||||||||||||||||||||||||||||||||||
|
2.0 CH <-> C2H2
|
||||||||||||||||||||||||||||||||||||
|
H + CH2 <-> H2 + CH
|
||||||||||||||||||||||||||||||||||||
|
H2 + CH2 <-> CH3 + H
|
||||||||||||||||||||||||||||||||||||
|
CH + CH2 <-> H + C2H2
|
||||||||||||||||||||||||||||||||||||
|
2.0 CH2 <-> C2H4
|
||||||||||||||||||||||||||||||||||||
|
2.0 CH2 <-> 2.0 H + C2H2
|
||||||||||||||||||||||||||||||||||||
|
2.0 CH2 <-> C2H2 + H2
|
||||||||||||||||||||||||||||||||||||
|
CH3 + H2 <-> CH4 + H
|
||||||||||||||||||||||||||||||||||||
|
CH3 + CH <-> H + C2H3
|
||||||||||||||||||||||||||||||||||||
|
CH3 + CH2 <-> H + C2H4
|
||||||||||||||||||||||||||||||||||||
|
2.0 CH3 <-> H + C2H5
|
||||||||||||||||||||||||||||||||||||
|
CH4 + CH <-> C2H5
|
||||||||||||||||||||||||||||||||||||
|
CH4 + CH <-> H + C2H4
|
||||||||||||||||||||||||||||||||||||
|
CH4 + CH2 <-> C2H6
|
||||||||||||||||||||||||||||||||||||
|
CH4 + CH2 <-> 2.0 CH3
|
||||||||||||||||||||||||||||||||||||
|
CH4 + CH3 <-> H2 + C2H5
|
||||||||||||||||||||||||||||||||||||
|
C2H + H2 <-> H + C2H2
|
||||||||||||||||||||||||||||||||||||
|
C2H + CH2 <-> C2H2 + CH
|
||||||||||||||||||||||||||||||||||||
|
CH4 + C2H <-> CH3 + C2H2
|
||||||||||||||||||||||||||||||||||||
|
H + C2H2 <-> C2H3
|
||||||||||||||||||||||||||||||||||||
|
C2H2 + H2 <-> H + C2H3
|
||||||||||||||||||||||||||||||||||||
|
2.0 C2H2 <-> C2H + C2H3
|
||||||||||||||||||||||||||||||||||||
|
C2H3 + M <-> H + C2H2 + M
|
||||||||||||||||||||||||||||||||||||
|
H2 + C2H3 <-> H + C2H4
|
||||||||||||||||||||||||||||||||||||
|
CH2 + C2H3 <-> CH3 + C2H2
|
||||||||||||||||||||||||||||||||||||
|
CH3 + C2H3 <-> CH4 + C2H2
|
||||||||||||||||||||||||||||||||||||
|
CH4 + C2H3 <-> CH3 + C2H4
|
||||||||||||||||||||||||||||||||||||
|
C2H4 + M <-> C2H2 + H2 + M
|
||||||||||||||||||||||||||||||||||||
|
C2H4 + M <-> H + C2H3 + M
|
||||||||||||||||||||||||||||||||||||
|
C2H4 + H2 <-> H + C2H5
|
||||||||||||||||||||||||||||||||||||
|
C2H2 + C2H4 <-> 2.0 C2H3
|
||||||||||||||||||||||||||||||||||||
|
2.0 C2H4 <-> C2H5 + C2H3
|
||||||||||||||||||||||||||||||||||||
|
H + C2H5 <-> C2H6
|
||||||||||||||||||||||||||||||||||||
|
H2 + C2H5 <-> H + C2H6
|
||||||||||||||||||||||||||||||||||||
|
CH3 + C2H5 <-> CH4 + C2H4
|
||||||||||||||||||||||||||||||||||||
|
CH4 + C2H5 <-> CH3 + C2H6
|
||||||||||||||||||||||||||||||||||||
|
C2H + C2H5 <-> C2H2 + C2H4
|
||||||||||||||||||||||||||||||||||||
|
C2H2 + C2H5 <-> C2H + C2H6
|
||||||||||||||||||||||||||||||||||||
|
C2H5 + C2H3 <-> C2H2 + C2H6
|
||||||||||||||||||||||||||||||||||||
|
C2H4 + C2H5 <-> C2H6 + C2H3
|
||||||||||||||||||||||||||||||||||||
|
2.0 C2H5 <-> C2H4 + C2H6
|
||||||||||||||||||||||||||||||||||||
|
C2H6 + CH2 <-> CH3 + C2H5
|
||||||||||||||||||||||||||||||||||||
|
SIH4 <-> H2 + SIH2
|
||||||||||||||||||||||||||||||||||||
|
SIH4 <-> H + SIH3
|
||||||||||||||||||||||||||||||||||||
|
SI2 <-> 2.0 SI
|
||||||||||||||||||||||||||||||||||||
|
H3SISIH <-> SIH4 + SI
|
||||||||||||||||||||||||||||||||||||
|
H3SISIH <-> H2 + SI2H2
|
||||||||||||||||||||||||||||||||||||
|
SI2H6 <-> SIH4 + SIH2
|
||||||||||||||||||||||||||||||||||||
|
SI3H8 <-> SIH2 + SI2H6
|
||||||||||||||||||||||||||||||||||||
|
SI3H8 <-> SIH4 + H3SISIH
|
||||||||||||||||||||||||||||||||||||
|
H2 + SIH <-> SIH3
|
||||||||||||||||||||||||||||||||||||
|
H + SIH2 <-> SIH3
|
||||||||||||||||||||||||||||||||||||
|
H + SIH2 <-> H2 + SIH
|
||||||||||||||||||||||||||||||||||||
|
SIH2 + SI <-> H2 + SI2
|
||||||||||||||||||||||||||||||||||||
|
SIH2 + SI <-> SI2H2
|
||||||||||||||||||||||||||||||||||||
|
2.0 SIH2 <-> H2 + SI2H2
|
||||||||||||||||||||||||||||||||||||
|
H + SIH3 <-> H2 + SIH2
|
||||||||||||||||||||||||||||||||||||
|
SIH2 + SIH3 <-> SI2H5
|
||||||||||||||||||||||||||||||||||||
|
2.0 SIH3 <-> SIH4 + SIH2
|
||||||||||||||||||||||||||||||||||||
|
H + SIH4 <-> H2 + SIH3
|
||||||||||||||||||||||||||||||||||||
|
SIH4 + SI <-> 2.0 SIH2
|
||||||||||||||||||||||||||||||||||||
|
SIH4 + SI <-> H2 + SI2H2
|
||||||||||||||||||||||||||||||||||||
|
SIH4 + SIH <-> SIH2 + SIH3
|
||||||||||||||||||||||||||||||||||||
|
SIH4 + SIH <-> H + H3SISIH
|
||||||||||||||||||||||||||||||||||||
|
SIH4 + SIH <-> SI2H5
|
||||||||||||||||||||||||||||||||||||
|
H + SI2 <-> SI + SIH
|
||||||||||||||||||||||||||||||||||||
|
H2 + SI2 <-> 2.0 SIH
|
||||||||||||||||||||||||||||||||||||
|
H2 + SI2 <-> SI2H2
|
||||||||||||||||||||||||||||||||||||
|
SIH2 + SI2 <-> H2 + SI3
|
||||||||||||||||||||||||||||||||||||
|
SI2 + SI <-> SI3
|
||||||||||||||||||||||||||||||||||||
|
H2 + H3SISIH <-> SIH4 + SIH2
|
||||||||||||||||||||||||||||||||||||
|
SIH4 + H3SISIH <-> SIH2 + SI2H6
|
||||||||||||||||||||||||||||||||||||
|
SIH3 + SI2H5 <-> SIH2 + SI2H6
|
||||||||||||||||||||||||||||||||||||
|
H + SI2H6 <-> H2 + SI2H5
|
||||||||||||||||||||||||||||||||||||
|
H + SI2H6 <-> SIH4 + SIH3
|
||||||||||||||||||||||||||||||||||||
|
SI + SI2H6 <-> SIH2 + H3SISIH
|
||||||||||||||||||||||||||||||||||||
|
SIH3 + SI2H6 <-> SIH4 + SI2H5
|
||||||||||||||||||||||||||||||||||||
|
H2 + SI3 <-> SI + SI2H2
|
||||||||||||||||||||||||||||||||||||
|
SI + SI3 <-> 2.0 SI2
|
||||||||||||||||||||||||||||||||||||
|
SIH2 + SI3 <-> SI2 + SI2H2
|
||||||||||||||||||||||||||||||||||||
|
HSICCH <-> H2 + SIC2
|
||||||||||||||||||||||||||||||||||||
|
H2CCHSIH <-> H2 + HSICCH
|
||||||||||||||||||||||||||||||||||||
|
H2CCHSIH3 <-> H2 + H2CCHSIH
|
||||||||||||||||||||||||||||||||||||
|
H3SICH3 <-> CH3 + SIH3
|
||||||||||||||||||||||||||||||||||||
|
H3SICH3 <-> H2 + HSICH3
|
||||||||||||||||||||||||||||||||||||
|
CH3SIH2SIH <-> 3.0 H2 + SI2C
|
||||||||||||||||||||||||||||||||||||
|
SIH3SIH2CH3 <-> H2 + CH3SIH2SIH
|
||||||||||||||||||||||||||||||||||||
|
CH4 + SIH2 <-> H3SICH3
|
||||||||||||||||||||||||||||||||||||
|
C2H2 + SIH2 <-> H3SICCH
|
||||||||||||||||||||||||||||||||||||
|
C2H2 + SIH2 <-> H2CCHSIH
|
||||||||||||||||||||||||||||||||||||
|
C2H4 + SIH2 <-> H2CCHSIH3
|
||||||||||||||||||||||||||||||||||||
|
CH3 + SIH3 <-> CH4 + SIH2
|
||||||||||||||||||||||||||||||||||||
|
CH2 + SIH4 <-> H3SICH3
|
||||||||||||||||||||||||||||||||||||
|
CH3 + SIH4 <-> CH4 + SIH3
|
||||||||||||||||||||||||||||||||||||
|
C2H5 + SIH4 <-> C2H6 + SIH3
|
||||||||||||||||||||||||||||||||||||
|
H + H3SICH3 <-> H2 + H2SICH3
|
||||||||||||||||||||||||||||||||||||
|
CH3 + H3SICH3 <-> CH4 + H2SICH3
|
||||||||||||||||||||||||||||||||||||
|
SIH2 + H3SICH3 <-> SIH3SIH2CH3
|
||||||||||||||||||||||||||||||||||||
|
CH4 + SI2 <-> 2.0 H2 + SI2C
|
||||||||||||||||||||||||||||||||||||
|
SIH3SIH2CH3 <-> SIH4 + HSICH3
|
||||||||||||||||||||||||||||||||||||
|
H + H2 <-> 3.0 H
|
||||||||||||||||||||||||||||||||||||
|
2.0 H2 <-> 2.0 H + H2
|
||||||||||||||||||||||||||||||||||||
|
2.0 H + M <-> H2 + M
|
||||||||||||||||||||||||||||||||||||
|
SI2H6 <-> H2 + H3SISIH
考慮した表面反応については,論文と同様に設定しました.論文では,H2 etching の考慮の有無について議論・検討していますが,以下の計算例は,表2の成膜ステップの他に,アレニウス型の H2 etching の step を始めから追加しています.
表2 シミュレーションで考慮した成長に寄与するガス種の付着係数
付着係数(sticking coeffient)は,反応面に熱運動速度で入射したガス種( species )が反応する割合を意味します. ガス流量は,論文の中で述べられている標準条件( SIH4/C3H8/H2 = 0.9/1.05/13000 sccm)を選んでいます.圧力は 1000 mbar(大気圧)としました. ■ 計算結果 始めに,計算領域全体の温度分布を Fig. 1 に示します(2次元軸対称モデルを利用しています). Fig. 1 SiC CVD 装置の温度分布 向って左側に inlet が配置されており,内径75mmの石英管の中を,導入したガスが左から右に向って流れます.温度の高い領域が下流側になびく様子は,先の熱解析モデルの結果と同様です.なお,コイルは銅パイプを仮定し,内部は水冷されており,100℃よりも低い温度を仮定しています. サセプター( graphite )近傍の温度と流速分布(流体部のみ)を Fig 2 に示します.
Fig. 2 ガス温度(上),及び,流速(下)の分布 考慮したガス種は,合計で36ありますが,以下では,成長・エッチングに寄与すると仮定されている species に関する質量分率( mass fraction )を示します
Fig. 3 SIH4(上)及び C3H8(下)の質量分率 SiC のソースとなる Si 及び C は,SIH4 と C3H8 の分解物から供給されますが,温度が1500℃前後となる領域で,どちらもほとんど分解している様子が分かります.
Fig. 4 CH(上)及び CH2(下)の質量分率
Fig. 5 CH3(上)及び CH4(下)の質量分率
Fig. 6 C2H(上)及び C2H2(下)の質量分率
Fig. 7 C2H3(上)及び C2H4(下)の質量分率
Fig. 8 C2H5(上)及び C2H6(下)の質量分率 CxHy は,親ガスである C3H8 の分解に伴い,温度の高い領域とその下流側で割合が高くなっている様子を確認できます.
Fig. 9 Si(上)及び SiH(下)の質量分率
Fig. 10 SiH2(上)及び SIH3(下)の質量分率
Fig. 11 SI2(上)及び SI3(下)の質量分率 SIH4 の分解物も,CxHy の分布と同様,主に温度の高い領域よりも下流側に分布しています.
Fig. 12 SI2C(上)及び H2(下)の質量分率 H2 は反応にも寄与しますが,キャリアガスとしても利用されており,流量を変えることで導入ガスが装置内に滞在する時間をも決めています. ■ 成長速度分布
Fig. 13 サセプター(graphite)上の成長速度分布 得られた成長速度は,ガス導入側から少し中央に寄った付近でピークを持つ傾向を示しており,論文で紹介されている実測の傾向を再現しています.また,定量的にも大差ありません.なお,論文で示されているシミュレーション結果には,3次元モデル利用されており,軸対称モデルと若干異なるようです. ■ サセプター近傍における各speciesの分圧
Fig. 14 サセプター近傍における species の分圧分布 気相反応における逆反応レートの与え方が若干異なるためか,分圧の分布は論文の結果とはやや異なるようですが,C2H2 や CH3,SiH2 や,Si,SIH3 等が比較的高い分圧を示す傾向が再現されています.なお,CH4,H 及び H2 の分圧は,論文と比較するために割愛しています(0.0001 [Pa] 以下の species についても割愛しています). さて,論文では分圧を示したところでグラフや図の説明は終わっていますが,少し進めて,分圧に付着係数を掛けた値を縦軸にとり,成長速度に対する寄与を確認してみます. ■ 成長速度への寄与
Fig. 15 成長速度に対する寄与とその分布 Fig. 12 より,SiC の成長速度に対し,Si のソースとしては SiH2 と Si が,また,C のソースとしては C2H2 が最も重要なことが分かります.CH4 は,付着係数は他と比べると小さいですが,分圧が高いために,その影響を無視出来ない可能性があることを確認出来ます. 論文では,成長した SiC の特性(結晶性・欠陥)に関しても,プロセス条件と比較・検討していますが,Fig. 15 のような傾向と対比させることで,どのような温度分布・分圧分布が理想的か,といった情報を得る手掛かりになると期待されます. ☆ 今回用いている反応モデルは,考慮している species やステップ数がかなり多いこともあり,今後,主要な species・ステップに絞ったモデルについても検討する予定です. ☆ |